LPCVD 低壓化學氣相沉積設備
LPCVD低壓化學氣相沉積設備(科研型LPCVD)是在低壓高溫的條件下,通過化學反應氣相外延的方法在襯底上沉積各種功能薄膜(主要是Si3N4、siO2及Poly硅薄膜)。 可用於科學研究、實踐教學、小型器件製造。
- 產品描述
-
LPCVD低壓化學氣相沉積設備(科研型LPCVD)是在低壓高溫的條件下,通過化學反應氣相外延的方法在襯底上沉積各種功能薄膜(主要是Si3N4、SiO2及Poly硅薄膜)。 可用於科學研究、實踐教學、小型器件製造。
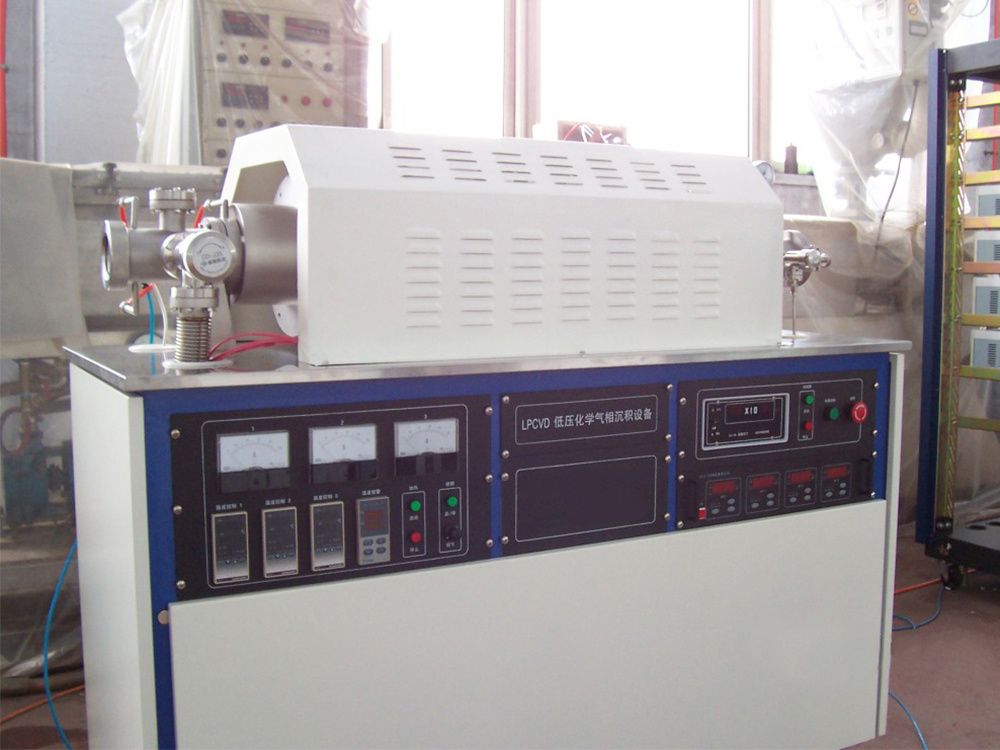
設備結構及特點
1、小型化,方便實驗室操作和使用,大幅降低實驗成本
兩種基片尺寸2英寸或4英寸;每次裝片1~ 3片。
基片放置方式:配置三種基片托架,豎直、水平臥式、帶傾角。
基片形狀類型:不規則形狀的散片、φ2~ 4英寸標準基片。
2、設備為水平管臥式結構
由石英管反應室、隔熱罩爐體櫃、電氣控制系統、真空系統、氣路系統、溫控系統、壓力控制系統及氣瓶櫃等系統組成。
反應室由高純石英製成,耐腐蝕、抗污染、漏率小、適合於高溫使用; 設備電控部分採用了先進的檢測和控制系統,量值準確,性能穩定、可靠。
LPCVD設備主要技術指標
LPCVD 低壓化學氣相沉積設備(生產型 LPCVD)類型
參數
成膜類型
你是。3N4、多晶矽、SiO2等
最高溫度
1200℃
恆溫區長度
根據用戶需要配置
恆溫區控溫精度
≤ ± 0.5 ℃
工作壓強範圍
13 ~ 1330Pa
膜層不均勻性
≤ ± 5%
基片每次裝載數量
標準基片:1~ 3片;不規則尺寸散片:若干
壓力控制
閉環充氣式控制
裝片方式
手動進出樣品
設備功能
該設備是在低壓高溫的條件下,通過化學反應氣相外延的方法在襯底上沉積各種功能薄膜(主要是Si3N4、siO2及Poly硅薄膜)。
可提供相關鍍膜工藝。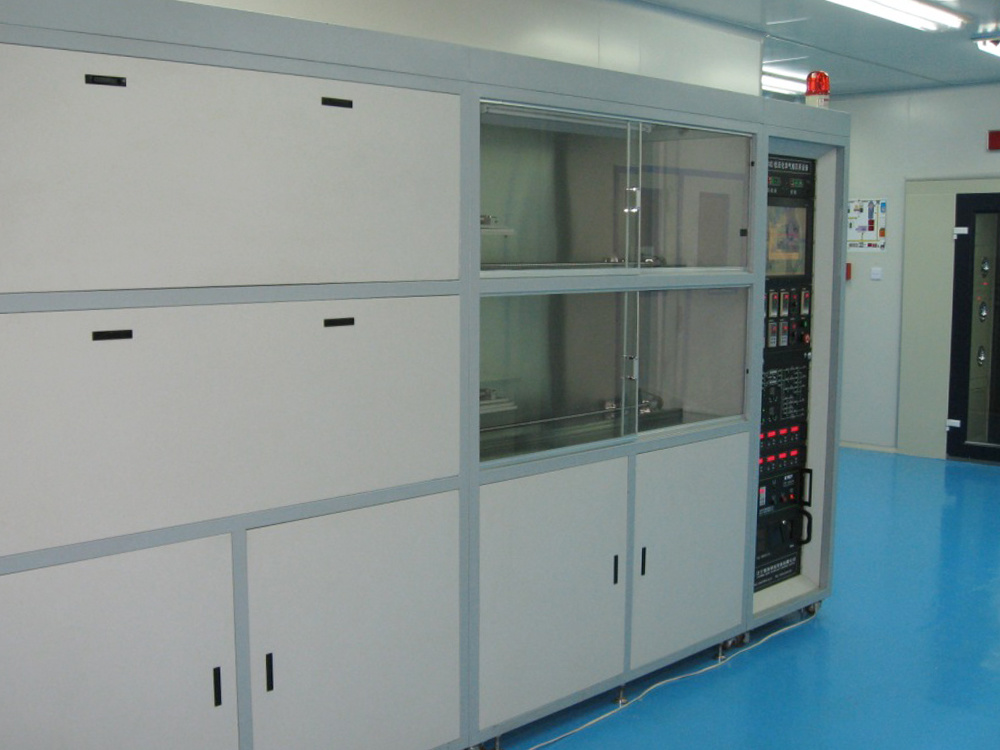
設備結構及特點:
設備為水平管臥式結構,由石英管反應室、隔熱罩爐體櫃、電氣控制系統、真空系統、氣路系統、溫控系統、壓力控制系統及氣瓶櫃等系統組成。
反應室由高純石英製成,耐腐蝕、抗污染、漏率小、適合於高溫使用; 設備電控部分採用了先進的檢測和控制系統,量值準確,性能穩定、可靠。
整個工藝過程由計算機對全部工藝流程進行管理,實現爐溫、氣體流量、壓力、閥門動作、泵的啟閉等工藝參數進行監測和自動控制。 也可以手動控制。
設備主要技術指標
LPCVD軟件控制界面類型
參數
成膜類型
你是。3N4、多晶矽、SiO2等
最高溫度
1200℃
恆溫區長度
根據用戶需要配置
恆溫區控溫精度
≤ ± 0.5 ℃
工作壓強範圍
13 ~ 1330Pa
膜層不均勻性
≤ ± 5%
基片每次裝載數量
100片
設備總功率
16kW
冷卻水用量
2米3/H
壓力控制
閉環充氣式控制
裝片方式
懸臂舟自動送樣

LPCVD手動運行界面
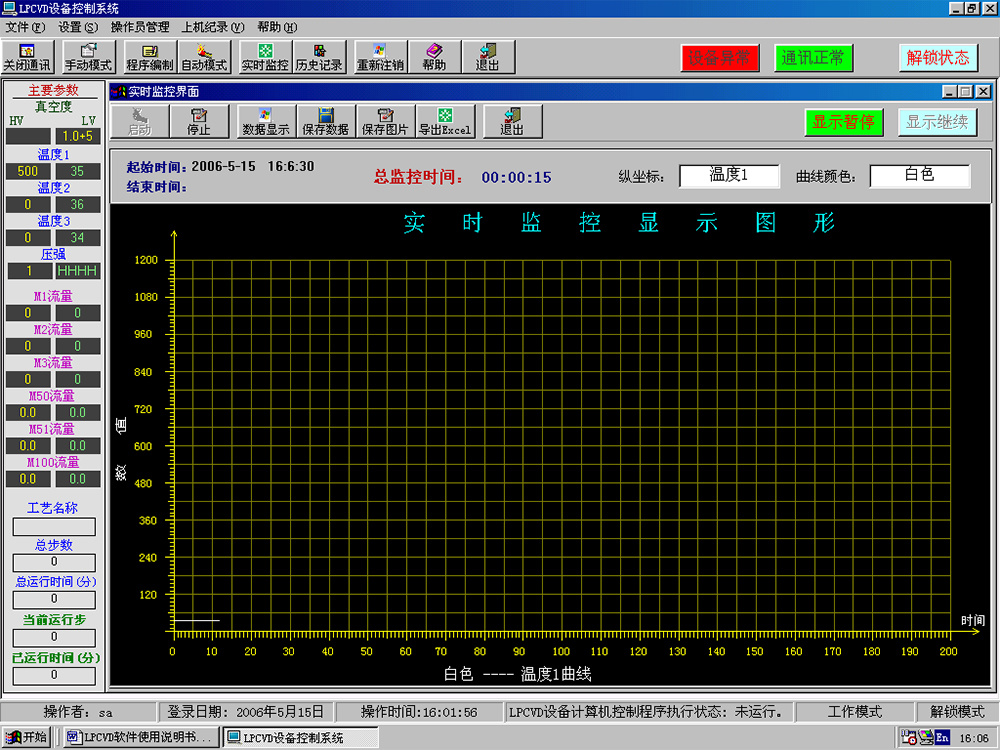
LPCVD實時運行監控界面

LPCVD自動運行界面

LPCVD工藝編制介面
關鍵詞:
獲取報價







